セメントキルン排ガスの処理システム及びその運転方法
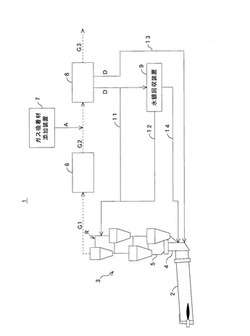
【課題】水銀と有機汚染物質の両方のセメント製造装置からの排出量を包括的に効率よく低減する。
【解決手段】セメント焼成装置のプレヒータ3から排出されるガスG2にガス吸着材Aを添加するガス吸着材添加装置7と、プレヒータの排ガスに含まれるダストを集塵する集塵装置8と、集塵したダストDに含まれる水銀を回収する水銀回収装置9とを備えるセメントキルン排ガス処理システム1。集塵装置で集塵したダストを直接プレヒータへ戻す第1循環ルート11と、集塵装置で集塵したダストを水銀回収装置を経由してプレヒータへ戻す第2循環ルート12と、集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルート13と、集塵装置で集塵したダストを水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルート14とを備えることができる。
【解決手段】セメント焼成装置のプレヒータ3から排出されるガスG2にガス吸着材Aを添加するガス吸着材添加装置7と、プレヒータの排ガスに含まれるダストを集塵する集塵装置8と、集塵したダストDに含まれる水銀を回収する水銀回収装置9とを備えるセメントキルン排ガス処理システム1。集塵装置で集塵したダストを直接プレヒータへ戻す第1循環ルート11と、集塵装置で集塵したダストを水銀回収装置を経由してプレヒータへ戻す第2循環ルート12と、集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルート13と、集塵装置で集塵したダストを水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルート14とを備えることができる。
【発明の詳細な説明】
【技術分野】
【0001】
本発明は、セメントキルン排ガスの処理システム及びその運転方法に関し、特に、セメントキルン排ガス中の水銀及び有機汚染物質の含有量を低減させることで、セメント製造装置の外部への排出量を低減するためのシステム等に関する。
【背景技術】
【0002】
セメントキルン排ガスには、極微量の金属水銀(Hg)が含まれている。その起源は、セメントの主原料である石灰石等の天然原料が含有する水銀の他、フライアッシュ等の多品種にわたるリサイクル資源に含まれる水銀である。今後、廃棄物のセメント原料化及び燃料化によるリサイクルが推進され、廃棄物の処理量が増加するに従い、セメントキルン排ガスに含まれる水銀濃度が増加する可能性が考えられる。
【0003】
そこで、例えば、特許文献1には、セメントの製造工程から排出される排ガスに含まれる水銀等を効率よく除去し、水銀等を除去した集塵ダストをセメント原料に再利用するため、セメントキルン排ガスを集塵機によって除塵した後、捕集した集塵ダストを加熱炉に導き、集塵ダスト中の水銀を揮発温度以上に加熱して揮発させ、その後、吸着材等により吸着して除去するセメント製造排ガスの処理方法が提案されている。
【0004】
一方、セメント原燃料として利用されるフライアッシュ、主灰、汚泥及び鉱滓等のリサイクル資源の中には、ダイオキシン類に代表される残留性有機汚染物質(POPs、Persistent Organic Pollutants)、もしくはその骨格となり得る成分を含むものが少なからず存在する。通常、セメント焼成を安定的に行っていれば、これらの有機汚染物質の大部分は、キルン排ガス集塵機ダストによって捕捉されてセメント製造装置内を循環し、高温域において分解されるため、キルン排ガスから大気中へ放出される有機汚染物質の量は極々僅かであり、当然のことながら排出規制を下回っている。
【0005】
しかし、セメント焼成に何らかのトラブルが発生して不安定になった場合、POPsが非意図的に再合成されてしまう可能性があり、キルン排ガスから大気中への排出量が増大してしまう虞を否定できない。そのため、これらの有機汚染物質の含有量をさらに低減することが望ましい。
【0006】
そこで、例えば、特許文献2には、有機汚染物質のセメント製造装置からの排出量を低減するため、プレヒータからの排ガスに含まれるダスト中の、有機汚染物質を吸着する固体炭素量を制御する有機汚染物質排出量低減方法が提案されている。
【先行技術文献】
【特許文献】
【0007】
【特許文献1】特開2002−355531号公報
【特許文献2】特開2008−222477号公報
【発明の概要】
【発明が解決しようとする課題】
【0008】
しかし、上記特許文献に記載の発明を実際にセメントキルン排ガスの処理に適用した場合には、セメントキルン排ガス中の水銀及び有機汚染物質を各々個別に処理することとなり、必ずしも効率的であるとは言えない面もあった。
【0009】
そこで、本発明は、水銀と有機汚染物質の両方のセメント製造装置からの排出量を包括的に効率よく低減することを目的とする。
【課題を解決するための手段】
【0010】
上記課題を解決するため、本発明は、セメントキルン排ガス処理システムであって、セメント焼成装置のプレヒータから排出されるガスにガス吸着材を添加するガス吸着材添加装置と、前記プレヒータの排ガスに含まれるダストを集塵する集塵装置と、該集塵したダストに含まれる水銀を回収する水銀回収装置とを備えることを特徴とする。ここで、有機汚染物質とは、ダイオキシン類(PCDD、PCDF、co−PCB)、ポリ塩化ビフェニル(PCBs)等の残留性有機汚染物質(POPs)や揮発性有機化合物(VOC)をいう。
【0011】
そして、本発明によれば、ガス吸着材添加装置により、セメント焼成装置のプレヒータから排出される排ガスに含まれる揮発した有機汚染物質をガス吸着材に吸着させ、ガス吸着材を集塵装置で集塵して回収すると共に、集塵したダストに含まれる水銀を水銀回収装置で回収することで、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に効率よく低減することができる。
【0012】
上記セメントキルン排ガス処理システムは、前記集塵装置で集塵したダストを直接前記プレヒータへ戻す第1循環ルートと、前記集塵装置で集塵したダストを前記水銀回収装置を経由して前記プレヒータへ戻す第2循環ルートと、前記集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルートと、前記集塵装置で集塵したダストを前記水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルートとを備えることができる。これによれば、セメント焼成装置からの排ガスの水銀濃度及び有機汚染物質濃度に応じて、集塵装置で集塵されたダストの循環ルートを適宜選択することができ、セメント製造装置から排出される水銀と有機汚染物質を、そのときの濃度に応じて包括的に低減することができる。
【0013】
上記セメントキルン排ガス処理システムにおいて、前記水銀回収装置は、前記集塵装置で集塵したダストを加熱し、該加熱によって揮発した水銀を回収すること、もしくは集塵したダストを洗浄し、該洗浄によって液体側に移行した水銀を回収することができる。
【0014】
また、本発明は、上記セメントキルン排ガス処理システムの運転方法であって、前記プレヒータから排出されるガスの水銀濃度及び有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第1循環ルートを経由して前記プレヒータに戻し、前記プレヒータから排出されるガスの水銀濃度が所定値以上で、かつ該排ガスの有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第2循環ルートを経由して前記プレヒータへ戻し、前記プレヒータから排出されるガスの水銀濃度が所定値未満で、かつ該排ガスの有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第3循環ルートを経由して前記セメントキルンの窯尻へ戻し、前記プレヒータからの排ガスの水銀濃度及び有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第4循環ルートを経由して前記セメントキルンの窯尻へ戻すことを特徴とする。
【0015】
そして、本発明によれば、上記発明と同様に、セメント焼成装置からの排ガスの水銀濃度及び有機汚染物質濃度に応じて、集塵装置で集塵されたダストの循環ルートを適宜選択することができ、セメント製造装置から排出される水銀と有機汚染物質を、そのときの濃度に応じて包括的に低減することができる。
【0016】
上記セメントキルン排ガス処理システムの運転方法において、前記集塵装置で集塵されたダストの疎水性固体状未燃炭素の含有率を0.2質量%以上とすることができる。これによれば、有機汚染物質の吸着効率を向上させ、効果的に有機汚染物質を回収することができる。
【発明の効果】
【0017】
以上のように、本発明によれば、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に効率よく低減することができる。
【図面の簡単な説明】
【0018】
【図1】本発明に係るセメントキルン排ガスの処理システムの一実施の形態を示す全体構成図である。
【図2】図1のセメントキルン排ガスの処理システムにおいて電気集塵装置の集塵ダストの疎水性固体状未燃炭素の含有率と、集塵装置出口のダイオキシン類(DXNs)濃度との関係を示すグラフである。
【発明を実施するための形態】
【0019】
次に、本発明の実施の形態について、図面を参照しながら詳細に説明する。
【0020】
図1は、本発明に係るセメントキルン排ガスの処理システムの一実施の形態を示し、この処理システム1は、セメントキルン2、プレヒータ3及び仮焼炉5を備えたセメント焼成装置に付設され、ボイラ等6を通過したプレヒータ3からの排ガスG2にガス吸着材Aを添加するガス吸着材添加装置7と、排ガスG2に含まれるダスト及びガス吸着材Aを集塵する電気集塵装置8と、電気集塵装置8で集塵されたダスト及びガス吸着材A(以下、「EPダストD」という)に含まれる水銀を回収する水銀回収装置9とで構成される。
【0021】
セメントキルン2、プレヒータ3、仮焼炉5及び電気集塵装置8は、セメント製造装置に一般的に用いられているものであり、これらについての詳細説明は省略する。尚、ボイラ等6とは、排ガスG1を用いて廃熱発電を行うボイラや、排ガスG1の調温・調湿を行うスタビライザ(調湿塔)や、プレヒータ3に供給するセメント原料Rを生成するためのドライヤ、ミル等の原料系の設備である。
【0022】
ガス吸着材添加装置7によって添加されるガス吸着材Aは、一般的にガス吸着に有効な多孔質材料であることが好ましい。さらには、この多孔質材料は、疎水性固体状未燃炭素を含有することがより好ましく、例えば、市販品の活性炭、各種産業から発生するフライアッシュ、ボトムアッシュ、オイルコークス燃焼灰等が挙げられる。
【0023】
ここで、疎水性固体状未燃炭素とは、固体状炭素のうち疎水性を有する多孔質の炭素質の粒子をいう。例えば、フライアッシュ等に含まれる全未燃炭素から、トルエンと水との液液抽出によってトルエン側で捕集される。
【0024】
さらに、疎水性固体状未燃炭素において、BET法による比表面積が30m2/g以上(好ましくは50m2/g以上)、BJH法によるメソ孔(2〜50nm)の細孔容積が0.03mL/g以上(好ましくは0.04mL/g以上、より好ましくは0.05mL/g以上)の構造を有するものが好適である。
【0025】
また、ガス吸着材Aの添加位置としては、電気集塵装置8の直前であることが好ましい。これは、排ガスG1がボイラ等6を通過することにより、温度が300℃以下に低下し、排ガスG1中の有機汚染物質の一部が生成・再合成するため、この位置でガス吸着材Aを添加することで、より効果的に有機汚染物質を吸着することができるからである。
【0026】
電気集塵装置8の後段には、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、EPダストDを循環させるための4つの循環ルート11〜14が配置される。第1循環ルート11は、EPダストDを直接プレヒータ3に戻し、第2循環ルート12は、EPダストDを水銀回収装置9を経由してプレヒータ3に戻し、第3循環ルート13は、EPダストDを直接セメントキルン2の窯尻4に戻し、第4循環ルート14は、EPダストDを水銀回収装置9を経由して窯尻4に戻すように各々構成される。
【0027】
水銀回収装置9は、電気集塵機8で集塵されたEPダストDに含まれる水銀を回収するために備えられる装置であり、水銀を効率よく回収し得るものであればよい。例えば、電気集塵装置8で集塵されたEPダストDを、水銀が揮発する温度以上に加熱することによりEPダストD中の水銀を揮発させ、その後、揮発した水銀を回収する装置、もしくは、EPダストDを水又は酸化剤の溶解した水を用いて洗浄することで、EPダストD中に含まれる水銀を液体側に移行させ、液体側に移行した水銀をキレート樹脂等の吸着材により回収する装置を備えることができる。
【0028】
水銀回収装置9において、EPダストDを加熱する方法は、間接加熱又は直接加熱とすることができる。EPダストDを間接加熱する装置としては、例えば、外熱式の加熱炉とすることができる。一方、EPダストDを直接的に加熱する装置としては、例えば、内熱式の気流炉とすることができる。ここで、EPダストDを加熱するための熱源としては、例えば、熱風発生装置により発生させた熱風とすることができるが、セメントキルン2やプレヒータ3の排ガス、セメントキルン2に付設されたクリンカクーラの排ガスを用いることもできる。
【0029】
間接加熱の場合には、外熱炉内の通風量を必要最小限に抑えることにより、EPダストDを加熱した後のガス中の水銀濃度を高めることができて好ましい。一方、直接加熱の場合には、EPダストDを加熱するための熱風が流れるダクト内に、EPダストDを熱風の流れに対向するように投入することで、EPダストを効率よく加熱することができるため、水銀も効率よくガス側に揮発させることができると共に、有機汚染物質の一部(PCB等)も回収することができる。EPダストDを気流炉で直接加熱する場合には、外熱炉で間接加熱する場合と比べて加熱効率が高く、必要な熱エネルギーが少なくて済む。
【0030】
水銀回収装置9において、EPダストDの加熱により揮発した水銀の回収方法は、例えば、乾式法又は湿式法とすることができる。乾式法は、吸着材を用いた吸着回収である。吸着材を充填した塔に水銀含有ガスを通すことにより、水銀を吸着回収する。使用する吸着材は、水銀を回収し得るものであればよく、最もよく知られる吸着材は活性炭である。また、活性炭以外の吸着材としては、水銀と反応し得る金属(アマルガム形成金属)、それらの代わりにアマルガム形成金属を担持した吸着材、これらを組み合わせたものでもよい。一方、湿式法は、揮発した水銀が水溶性の形態をとる場合に適用することができる。この場合、水溶性の水銀を含有するガスをスクラバー等で湿式洗浄し、水銀を液体側に移行させ、液体側に移行した水銀をキレート樹脂等の吸着材により回収することができる。
【0031】
EPダストDの加熱により揮発した水銀の回収に関して、EPダストDから揮発した水銀の形態が不溶性の金属水銀であっても、湿式法を適用したい場合には、EPダストDを加熱する前後の上記排ガス等に塩素又は塩素化合物を添加し、EPダストから揮発した水銀を水溶性の塩化水銀等へ積極的に転化させることにより、効率よく水銀を回収することができる。また、EPダストDの加熱に用いる熱風中に塩素化合物が含まれている場合には、塩素又は塩素化合物の添加量を最適に制御することにより、水銀の塩素化反応を無駄なく効率よく行うことができる。
【0032】
次に、上記構成を有するセメントキルンの排ガス処理システム1の動作について、図1を参照しながら説明する。
【0033】
セメントキルン2の運転時に、プレヒータ3に供給されたセメント原料Rは、プレヒータ3で予熱され、仮焼炉5で仮焼された後、セメントキルン2にて焼成されてセメントクリンカが生成される。一方、セメントキルン2から排出された排ガスは、セメントキルン2の窯尻4、仮焼炉5を経てプレヒータ3から排出され、プレヒータからの排ガスG1をファン等(不図示)を介して電気集塵装置8に導入する。
そして、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、循環ルート11〜14の選択を行い、電気集塵装置8で捕集したEPダストDを、以下に示す要領で循環させる。尚、電気集塵装置8でEPダストDを捕集した後の排ガスG3は、大気へ放出される。
【0034】
排ガスG1の水銀濃度及び有機汚染物質濃度が所定値未満の場合には、EPダストDを第1循環ルート11を介して直接プレヒータ3へ戻す。このとき、EPダストD中のガス吸着材Aは、セメント製造装置内を循環するため、ガス吸着材添加装置7からガス吸着材Aを添加する必要はない。
【0035】
次に、排ガスG1の水銀濃度が所定値以上で、かつ有機汚染物質濃度が所定値未満の場合には、水銀濃度を低減する必要があるため、EPダストDを第2循環ルート12へ供給し、水銀回収装置9で水銀を回収した後、プレヒータ3へ戻す。これにより、セメント製造装置からの排ガスG1の水銀濃度を低減することができる。尚、この場合も、有機汚染物質濃度が所定値未満であるため、上記と同様、ガス吸着材Aを添加する必要はない。
【0036】
また、排ガスG1の水銀濃度が所定値未満で、かつ有機汚染物質濃度が所定値以上の場合には、有機汚染物質濃度を低減する必要があるため、EPダストDを第3循環ルート13を介して直接セメントキルン2の、900〜1100℃と高温の窯尻4へ戻すことで、EPダストD中の有機汚染物質を燃焼分解することができる。これにより、セメント製造装置からの排ガスG1の有機汚染物質濃度を低減することができる。ここで、窯尻4に投入されたEPダストDに含まれるガス吸着材Aの一部が燃焼してしまうため、ガス吸着材添加装置7により排ガスG1にガス吸着材Aを添加する。
【0037】
排ガスG1の水銀濃度及び有機汚染物質濃度が所定値以上の場合には、水銀及び有機汚染物質の両方の濃度を低減する必要があるため、EPダストDを第4循環ルート14へ供給し、水銀回収装置9で水銀を回収した後、セメントキルン2の窯尻4へ戻す。これにより、セメント製造装置からの排ガスG1の水銀及び有機汚染物質濃度を低減することができる。尚、この場合も、窯尻4に投入されたEPダストDに含まれるガス吸着材Aの一部が燃焼してしまうため、上記と同様、排ガスG1にガス吸着材Aを添加する。
【0038】
以上のように、本実施の形態によれば、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に低減することができる。
【0039】
尚、上記実施の形態では、セメントキルン2の排ガスG2に含まれるダストを捕集するために電気集塵装置8を配置するが、電気集塵装置8に代えて、バグフィルタ、サイクロン、移動式集塵装置等を配置し、それら集塵装置によって排ガスG2に含まれるダストを捕集し、各循環ルート11〜14に搬送するようにしてもよい。
【実施例】
【0040】
セメントキルン2の運転時に、ガス吸着材添加装置7により排ガスG1に上記ガス吸着材Aを添加して有機汚染物質を吸着した。図2は、その際に、集塵装置8で回収されたEPダストDの疎水性固体状未燃炭素含有率と、集塵装置8の排ガスG3中のダイオキシン類(DXNs)の濃度との関係を示すグラフである。
【0041】
疎水性固体状未燃炭素含有率は、EPダストDをトルエンを用いて液液抽出し、トルエン側に捕集された固体成分を分離後、塩酸を添加して処理し、再び固液分離をして乾燥させた物質(残渣)の重量を秤量して当初のEPダスト量をもとに残分率を求め、残分率及び残渣中の炭素量測定値をもとに、以下の計算式を用いて算出した。
【0042】
疎水性固体状未燃炭素含有率(質量%)=残渣中の炭素量測定値(質量%)×残分率(質量%)/100
このグラフから明らかなように、集塵装置8で回収されたEPダストDの疎水性固体状未燃炭素量が増加するに伴い、集塵装置8の排ガスG3中のダイオキシン類の濃度が減少するという負の相関を有していることが分かる。そして、集塵装置8で回収された集塵ダストDの疎水性固体状未燃炭素含有率が0.2質量%以上となるように、ガス吸着材添加装置7から集塵装置8の入口ダクト等へ吸着材Aを投入することで、排ガスG3中のダイオキシン類の濃度を環境基準の0.1ng−TEQ/m3N以下に低減することができる。
【符号の説明】
【0043】
1 セメントキルン排ガスの処理システム
2 セメントキルン
3 プレヒータ
4 窯尻
5 仮焼炉
6 ボイラ等
7 ガス吸着材添加装置
8 電気集塵装置
9 水銀回収装置
11 第1循環ルート
12 第2循環ルート
13 第3循環ルート
14 第4循環ルート
D EPダスト
G1〜G3 排ガス
【技術分野】
【0001】
本発明は、セメントキルン排ガスの処理システム及びその運転方法に関し、特に、セメントキルン排ガス中の水銀及び有機汚染物質の含有量を低減させることで、セメント製造装置の外部への排出量を低減するためのシステム等に関する。
【背景技術】
【0002】
セメントキルン排ガスには、極微量の金属水銀(Hg)が含まれている。その起源は、セメントの主原料である石灰石等の天然原料が含有する水銀の他、フライアッシュ等の多品種にわたるリサイクル資源に含まれる水銀である。今後、廃棄物のセメント原料化及び燃料化によるリサイクルが推進され、廃棄物の処理量が増加するに従い、セメントキルン排ガスに含まれる水銀濃度が増加する可能性が考えられる。
【0003】
そこで、例えば、特許文献1には、セメントの製造工程から排出される排ガスに含まれる水銀等を効率よく除去し、水銀等を除去した集塵ダストをセメント原料に再利用するため、セメントキルン排ガスを集塵機によって除塵した後、捕集した集塵ダストを加熱炉に導き、集塵ダスト中の水銀を揮発温度以上に加熱して揮発させ、その後、吸着材等により吸着して除去するセメント製造排ガスの処理方法が提案されている。
【0004】
一方、セメント原燃料として利用されるフライアッシュ、主灰、汚泥及び鉱滓等のリサイクル資源の中には、ダイオキシン類に代表される残留性有機汚染物質(POPs、Persistent Organic Pollutants)、もしくはその骨格となり得る成分を含むものが少なからず存在する。通常、セメント焼成を安定的に行っていれば、これらの有機汚染物質の大部分は、キルン排ガス集塵機ダストによって捕捉されてセメント製造装置内を循環し、高温域において分解されるため、キルン排ガスから大気中へ放出される有機汚染物質の量は極々僅かであり、当然のことながら排出規制を下回っている。
【0005】
しかし、セメント焼成に何らかのトラブルが発生して不安定になった場合、POPsが非意図的に再合成されてしまう可能性があり、キルン排ガスから大気中への排出量が増大してしまう虞を否定できない。そのため、これらの有機汚染物質の含有量をさらに低減することが望ましい。
【0006】
そこで、例えば、特許文献2には、有機汚染物質のセメント製造装置からの排出量を低減するため、プレヒータからの排ガスに含まれるダスト中の、有機汚染物質を吸着する固体炭素量を制御する有機汚染物質排出量低減方法が提案されている。
【先行技術文献】
【特許文献】
【0007】
【特許文献1】特開2002−355531号公報
【特許文献2】特開2008−222477号公報
【発明の概要】
【発明が解決しようとする課題】
【0008】
しかし、上記特許文献に記載の発明を実際にセメントキルン排ガスの処理に適用した場合には、セメントキルン排ガス中の水銀及び有機汚染物質を各々個別に処理することとなり、必ずしも効率的であるとは言えない面もあった。
【0009】
そこで、本発明は、水銀と有機汚染物質の両方のセメント製造装置からの排出量を包括的に効率よく低減することを目的とする。
【課題を解決するための手段】
【0010】
上記課題を解決するため、本発明は、セメントキルン排ガス処理システムであって、セメント焼成装置のプレヒータから排出されるガスにガス吸着材を添加するガス吸着材添加装置と、前記プレヒータの排ガスに含まれるダストを集塵する集塵装置と、該集塵したダストに含まれる水銀を回収する水銀回収装置とを備えることを特徴とする。ここで、有機汚染物質とは、ダイオキシン類(PCDD、PCDF、co−PCB)、ポリ塩化ビフェニル(PCBs)等の残留性有機汚染物質(POPs)や揮発性有機化合物(VOC)をいう。
【0011】
そして、本発明によれば、ガス吸着材添加装置により、セメント焼成装置のプレヒータから排出される排ガスに含まれる揮発した有機汚染物質をガス吸着材に吸着させ、ガス吸着材を集塵装置で集塵して回収すると共に、集塵したダストに含まれる水銀を水銀回収装置で回収することで、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に効率よく低減することができる。
【0012】
上記セメントキルン排ガス処理システムは、前記集塵装置で集塵したダストを直接前記プレヒータへ戻す第1循環ルートと、前記集塵装置で集塵したダストを前記水銀回収装置を経由して前記プレヒータへ戻す第2循環ルートと、前記集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルートと、前記集塵装置で集塵したダストを前記水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルートとを備えることができる。これによれば、セメント焼成装置からの排ガスの水銀濃度及び有機汚染物質濃度に応じて、集塵装置で集塵されたダストの循環ルートを適宜選択することができ、セメント製造装置から排出される水銀と有機汚染物質を、そのときの濃度に応じて包括的に低減することができる。
【0013】
上記セメントキルン排ガス処理システムにおいて、前記水銀回収装置は、前記集塵装置で集塵したダストを加熱し、該加熱によって揮発した水銀を回収すること、もしくは集塵したダストを洗浄し、該洗浄によって液体側に移行した水銀を回収することができる。
【0014】
また、本発明は、上記セメントキルン排ガス処理システムの運転方法であって、前記プレヒータから排出されるガスの水銀濃度及び有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第1循環ルートを経由して前記プレヒータに戻し、前記プレヒータから排出されるガスの水銀濃度が所定値以上で、かつ該排ガスの有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第2循環ルートを経由して前記プレヒータへ戻し、前記プレヒータから排出されるガスの水銀濃度が所定値未満で、かつ該排ガスの有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第3循環ルートを経由して前記セメントキルンの窯尻へ戻し、前記プレヒータからの排ガスの水銀濃度及び有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第4循環ルートを経由して前記セメントキルンの窯尻へ戻すことを特徴とする。
【0015】
そして、本発明によれば、上記発明と同様に、セメント焼成装置からの排ガスの水銀濃度及び有機汚染物質濃度に応じて、集塵装置で集塵されたダストの循環ルートを適宜選択することができ、セメント製造装置から排出される水銀と有機汚染物質を、そのときの濃度に応じて包括的に低減することができる。
【0016】
上記セメントキルン排ガス処理システムの運転方法において、前記集塵装置で集塵されたダストの疎水性固体状未燃炭素の含有率を0.2質量%以上とすることができる。これによれば、有機汚染物質の吸着効率を向上させ、効果的に有機汚染物質を回収することができる。
【発明の効果】
【0017】
以上のように、本発明によれば、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に効率よく低減することができる。
【図面の簡単な説明】
【0018】
【図1】本発明に係るセメントキルン排ガスの処理システムの一実施の形態を示す全体構成図である。
【図2】図1のセメントキルン排ガスの処理システムにおいて電気集塵装置の集塵ダストの疎水性固体状未燃炭素の含有率と、集塵装置出口のダイオキシン類(DXNs)濃度との関係を示すグラフである。
【発明を実施するための形態】
【0019】
次に、本発明の実施の形態について、図面を参照しながら詳細に説明する。
【0020】
図1は、本発明に係るセメントキルン排ガスの処理システムの一実施の形態を示し、この処理システム1は、セメントキルン2、プレヒータ3及び仮焼炉5を備えたセメント焼成装置に付設され、ボイラ等6を通過したプレヒータ3からの排ガスG2にガス吸着材Aを添加するガス吸着材添加装置7と、排ガスG2に含まれるダスト及びガス吸着材Aを集塵する電気集塵装置8と、電気集塵装置8で集塵されたダスト及びガス吸着材A(以下、「EPダストD」という)に含まれる水銀を回収する水銀回収装置9とで構成される。
【0021】
セメントキルン2、プレヒータ3、仮焼炉5及び電気集塵装置8は、セメント製造装置に一般的に用いられているものであり、これらについての詳細説明は省略する。尚、ボイラ等6とは、排ガスG1を用いて廃熱発電を行うボイラや、排ガスG1の調温・調湿を行うスタビライザ(調湿塔)や、プレヒータ3に供給するセメント原料Rを生成するためのドライヤ、ミル等の原料系の設備である。
【0022】
ガス吸着材添加装置7によって添加されるガス吸着材Aは、一般的にガス吸着に有効な多孔質材料であることが好ましい。さらには、この多孔質材料は、疎水性固体状未燃炭素を含有することがより好ましく、例えば、市販品の活性炭、各種産業から発生するフライアッシュ、ボトムアッシュ、オイルコークス燃焼灰等が挙げられる。
【0023】
ここで、疎水性固体状未燃炭素とは、固体状炭素のうち疎水性を有する多孔質の炭素質の粒子をいう。例えば、フライアッシュ等に含まれる全未燃炭素から、トルエンと水との液液抽出によってトルエン側で捕集される。
【0024】
さらに、疎水性固体状未燃炭素において、BET法による比表面積が30m2/g以上(好ましくは50m2/g以上)、BJH法によるメソ孔(2〜50nm)の細孔容積が0.03mL/g以上(好ましくは0.04mL/g以上、より好ましくは0.05mL/g以上)の構造を有するものが好適である。
【0025】
また、ガス吸着材Aの添加位置としては、電気集塵装置8の直前であることが好ましい。これは、排ガスG1がボイラ等6を通過することにより、温度が300℃以下に低下し、排ガスG1中の有機汚染物質の一部が生成・再合成するため、この位置でガス吸着材Aを添加することで、より効果的に有機汚染物質を吸着することができるからである。
【0026】
電気集塵装置8の後段には、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、EPダストDを循環させるための4つの循環ルート11〜14が配置される。第1循環ルート11は、EPダストDを直接プレヒータ3に戻し、第2循環ルート12は、EPダストDを水銀回収装置9を経由してプレヒータ3に戻し、第3循環ルート13は、EPダストDを直接セメントキルン2の窯尻4に戻し、第4循環ルート14は、EPダストDを水銀回収装置9を経由して窯尻4に戻すように各々構成される。
【0027】
水銀回収装置9は、電気集塵機8で集塵されたEPダストDに含まれる水銀を回収するために備えられる装置であり、水銀を効率よく回収し得るものであればよい。例えば、電気集塵装置8で集塵されたEPダストDを、水銀が揮発する温度以上に加熱することによりEPダストD中の水銀を揮発させ、その後、揮発した水銀を回収する装置、もしくは、EPダストDを水又は酸化剤の溶解した水を用いて洗浄することで、EPダストD中に含まれる水銀を液体側に移行させ、液体側に移行した水銀をキレート樹脂等の吸着材により回収する装置を備えることができる。
【0028】
水銀回収装置9において、EPダストDを加熱する方法は、間接加熱又は直接加熱とすることができる。EPダストDを間接加熱する装置としては、例えば、外熱式の加熱炉とすることができる。一方、EPダストDを直接的に加熱する装置としては、例えば、内熱式の気流炉とすることができる。ここで、EPダストDを加熱するための熱源としては、例えば、熱風発生装置により発生させた熱風とすることができるが、セメントキルン2やプレヒータ3の排ガス、セメントキルン2に付設されたクリンカクーラの排ガスを用いることもできる。
【0029】
間接加熱の場合には、外熱炉内の通風量を必要最小限に抑えることにより、EPダストDを加熱した後のガス中の水銀濃度を高めることができて好ましい。一方、直接加熱の場合には、EPダストDを加熱するための熱風が流れるダクト内に、EPダストDを熱風の流れに対向するように投入することで、EPダストを効率よく加熱することができるため、水銀も効率よくガス側に揮発させることができると共に、有機汚染物質の一部(PCB等)も回収することができる。EPダストDを気流炉で直接加熱する場合には、外熱炉で間接加熱する場合と比べて加熱効率が高く、必要な熱エネルギーが少なくて済む。
【0030】
水銀回収装置9において、EPダストDの加熱により揮発した水銀の回収方法は、例えば、乾式法又は湿式法とすることができる。乾式法は、吸着材を用いた吸着回収である。吸着材を充填した塔に水銀含有ガスを通すことにより、水銀を吸着回収する。使用する吸着材は、水銀を回収し得るものであればよく、最もよく知られる吸着材は活性炭である。また、活性炭以外の吸着材としては、水銀と反応し得る金属(アマルガム形成金属)、それらの代わりにアマルガム形成金属を担持した吸着材、これらを組み合わせたものでもよい。一方、湿式法は、揮発した水銀が水溶性の形態をとる場合に適用することができる。この場合、水溶性の水銀を含有するガスをスクラバー等で湿式洗浄し、水銀を液体側に移行させ、液体側に移行した水銀をキレート樹脂等の吸着材により回収することができる。
【0031】
EPダストDの加熱により揮発した水銀の回収に関して、EPダストDから揮発した水銀の形態が不溶性の金属水銀であっても、湿式法を適用したい場合には、EPダストDを加熱する前後の上記排ガス等に塩素又は塩素化合物を添加し、EPダストから揮発した水銀を水溶性の塩化水銀等へ積極的に転化させることにより、効率よく水銀を回収することができる。また、EPダストDの加熱に用いる熱風中に塩素化合物が含まれている場合には、塩素又は塩素化合物の添加量を最適に制御することにより、水銀の塩素化反応を無駄なく効率よく行うことができる。
【0032】
次に、上記構成を有するセメントキルンの排ガス処理システム1の動作について、図1を参照しながら説明する。
【0033】
セメントキルン2の運転時に、プレヒータ3に供給されたセメント原料Rは、プレヒータ3で予熱され、仮焼炉5で仮焼された後、セメントキルン2にて焼成されてセメントクリンカが生成される。一方、セメントキルン2から排出された排ガスは、セメントキルン2の窯尻4、仮焼炉5を経てプレヒータ3から排出され、プレヒータからの排ガスG1をファン等(不図示)を介して電気集塵装置8に導入する。
そして、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、循環ルート11〜14の選択を行い、電気集塵装置8で捕集したEPダストDを、以下に示す要領で循環させる。尚、電気集塵装置8でEPダストDを捕集した後の排ガスG3は、大気へ放出される。
【0034】
排ガスG1の水銀濃度及び有機汚染物質濃度が所定値未満の場合には、EPダストDを第1循環ルート11を介して直接プレヒータ3へ戻す。このとき、EPダストD中のガス吸着材Aは、セメント製造装置内を循環するため、ガス吸着材添加装置7からガス吸着材Aを添加する必要はない。
【0035】
次に、排ガスG1の水銀濃度が所定値以上で、かつ有機汚染物質濃度が所定値未満の場合には、水銀濃度を低減する必要があるため、EPダストDを第2循環ルート12へ供給し、水銀回収装置9で水銀を回収した後、プレヒータ3へ戻す。これにより、セメント製造装置からの排ガスG1の水銀濃度を低減することができる。尚、この場合も、有機汚染物質濃度が所定値未満であるため、上記と同様、ガス吸着材Aを添加する必要はない。
【0036】
また、排ガスG1の水銀濃度が所定値未満で、かつ有機汚染物質濃度が所定値以上の場合には、有機汚染物質濃度を低減する必要があるため、EPダストDを第3循環ルート13を介して直接セメントキルン2の、900〜1100℃と高温の窯尻4へ戻すことで、EPダストD中の有機汚染物質を燃焼分解することができる。これにより、セメント製造装置からの排ガスG1の有機汚染物質濃度を低減することができる。ここで、窯尻4に投入されたEPダストDに含まれるガス吸着材Aの一部が燃焼してしまうため、ガス吸着材添加装置7により排ガスG1にガス吸着材Aを添加する。
【0037】
排ガスG1の水銀濃度及び有機汚染物質濃度が所定値以上の場合には、水銀及び有機汚染物質の両方の濃度を低減する必要があるため、EPダストDを第4循環ルート14へ供給し、水銀回収装置9で水銀を回収した後、セメントキルン2の窯尻4へ戻す。これにより、セメント製造装置からの排ガスG1の水銀及び有機汚染物質濃度を低減することができる。尚、この場合も、窯尻4に投入されたEPダストDに含まれるガス吸着材Aの一部が燃焼してしまうため、上記と同様、排ガスG1にガス吸着材Aを添加する。
【0038】
以上のように、本実施の形態によれば、排ガスG1の水銀濃度及び有機汚染物質濃度に応じて、セメント製造装置から排出される水銀と有機汚染物質の両方を包括的に低減することができる。
【0039】
尚、上記実施の形態では、セメントキルン2の排ガスG2に含まれるダストを捕集するために電気集塵装置8を配置するが、電気集塵装置8に代えて、バグフィルタ、サイクロン、移動式集塵装置等を配置し、それら集塵装置によって排ガスG2に含まれるダストを捕集し、各循環ルート11〜14に搬送するようにしてもよい。
【実施例】
【0040】
セメントキルン2の運転時に、ガス吸着材添加装置7により排ガスG1に上記ガス吸着材Aを添加して有機汚染物質を吸着した。図2は、その際に、集塵装置8で回収されたEPダストDの疎水性固体状未燃炭素含有率と、集塵装置8の排ガスG3中のダイオキシン類(DXNs)の濃度との関係を示すグラフである。
【0041】
疎水性固体状未燃炭素含有率は、EPダストDをトルエンを用いて液液抽出し、トルエン側に捕集された固体成分を分離後、塩酸を添加して処理し、再び固液分離をして乾燥させた物質(残渣)の重量を秤量して当初のEPダスト量をもとに残分率を求め、残分率及び残渣中の炭素量測定値をもとに、以下の計算式を用いて算出した。
【0042】
疎水性固体状未燃炭素含有率(質量%)=残渣中の炭素量測定値(質量%)×残分率(質量%)/100
このグラフから明らかなように、集塵装置8で回収されたEPダストDの疎水性固体状未燃炭素量が増加するに伴い、集塵装置8の排ガスG3中のダイオキシン類の濃度が減少するという負の相関を有していることが分かる。そして、集塵装置8で回収された集塵ダストDの疎水性固体状未燃炭素含有率が0.2質量%以上となるように、ガス吸着材添加装置7から集塵装置8の入口ダクト等へ吸着材Aを投入することで、排ガスG3中のダイオキシン類の濃度を環境基準の0.1ng−TEQ/m3N以下に低減することができる。
【符号の説明】
【0043】
1 セメントキルン排ガスの処理システム
2 セメントキルン
3 プレヒータ
4 窯尻
5 仮焼炉
6 ボイラ等
7 ガス吸着材添加装置
8 電気集塵装置
9 水銀回収装置
11 第1循環ルート
12 第2循環ルート
13 第3循環ルート
14 第4循環ルート
D EPダスト
G1〜G3 排ガス
【特許請求の範囲】
【請求項1】
セメント焼成装置のプレヒータから排出されるガスにガス吸着材を添加するガス吸着材添加装置と、
前記プレヒータの排ガスに含まれるダストを集塵する集塵装置と、
該集塵したダストに含まれる水銀を回収する水銀回収装置とを備えることを特徴とするセメントキルン排ガス処理システム。
【請求項2】
前記集塵装置で集塵したダストを直接前記プレヒータへ戻す第1循環ルートと、
前記集塵装置で集塵したダストを前記水銀回収装置を経由して前記プレヒータへ戻す第2循環ルートと、
前記集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルートと、
前記集塵装置で集塵したダストを前記水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルートとを備えることを特徴とする請求項1に記載のセメントキルン排ガス処理システム。
【請求項3】
前記水銀回収装置は、前記集塵装置で集塵したダストを加熱し、該加熱によって揮発した水銀を回収すること、もしくは集塵したダストを洗浄し、該洗浄によって液体側に移行した水銀を回収することを特徴とする請求項1又は2に記載のセメントキルン排ガス処理システム。
【請求項4】
請求項2又は3に記載のセメントキルン排ガス処理システムの運転方法であって、
前記プレヒータから排出されるガスの水銀濃度及び有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第1循環ルートを経由して前記プレヒータに戻し、
前記プレヒータから排出されるガスの水銀濃度が所定値以上で、かつ該排ガスの有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第2循環ルートを経由して前記プレヒータへ戻し、
前記プレヒータから排出されるガスの水銀濃度が所定値未満で、かつ該排ガスの有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第3循環ルートを経由して前記セメントキルンの窯尻へ戻し、
前記プレヒータからの排ガスの水銀濃度及び有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第4循環ルートを経由して前記セメントキルンの窯尻へ戻すことを特徴とするセメントキルン排ガス処理システムの運転方法。
【請求項5】
前記集塵装置で集塵されたダストの疎水性固体状未燃炭素の含有率が0.2質量%以上であることを特徴とする請求項4に記載のセメントキルン排ガス処理システムの運転方法。
【請求項1】
セメント焼成装置のプレヒータから排出されるガスにガス吸着材を添加するガス吸着材添加装置と、
前記プレヒータの排ガスに含まれるダストを集塵する集塵装置と、
該集塵したダストに含まれる水銀を回収する水銀回収装置とを備えることを特徴とするセメントキルン排ガス処理システム。
【請求項2】
前記集塵装置で集塵したダストを直接前記プレヒータへ戻す第1循環ルートと、
前記集塵装置で集塵したダストを前記水銀回収装置を経由して前記プレヒータへ戻す第2循環ルートと、
前記集塵装置で集塵したダストを直接セメントキルンの窯尻へ戻す第3循環ルートと、
前記集塵装置で集塵したダストを前記水銀回収装置を経由してセメントキルンの窯尻へ戻す第4循環ルートとを備えることを特徴とする請求項1に記載のセメントキルン排ガス処理システム。
【請求項3】
前記水銀回収装置は、前記集塵装置で集塵したダストを加熱し、該加熱によって揮発した水銀を回収すること、もしくは集塵したダストを洗浄し、該洗浄によって液体側に移行した水銀を回収することを特徴とする請求項1又は2に記載のセメントキルン排ガス処理システム。
【請求項4】
請求項2又は3に記載のセメントキルン排ガス処理システムの運転方法であって、
前記プレヒータから排出されるガスの水銀濃度及び有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第1循環ルートを経由して前記プレヒータに戻し、
前記プレヒータから排出されるガスの水銀濃度が所定値以上で、かつ該排ガスの有機汚染物質濃度が所定値未満の場合には、前記ガス吸着材の添加を中止すると共に、前記ダストを前記第2循環ルートを経由して前記プレヒータへ戻し、
前記プレヒータから排出されるガスの水銀濃度が所定値未満で、かつ該排ガスの有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第3循環ルートを経由して前記セメントキルンの窯尻へ戻し、
前記プレヒータからの排ガスの水銀濃度及び有機汚染物質濃度が所定値以上の場合には、該排ガスに前記ガス吸着材を添加すると共に、該排ガスに含まれるダストを前記第4循環ルートを経由して前記セメントキルンの窯尻へ戻すことを特徴とするセメントキルン排ガス処理システムの運転方法。
【請求項5】
前記集塵装置で集塵されたダストの疎水性固体状未燃炭素の含有率が0.2質量%以上であることを特徴とする請求項4に記載のセメントキルン排ガス処理システムの運転方法。
【図1】


【図2】




【図2】


【公開番号】特開2013−112579(P2013−112579A)
【公開日】平成25年6月10日(2013.6.10)
【国際特許分類】
【出願番号】特願2011−261653(P2011−261653)
【出願日】平成23年11月30日(2011.11.30)
【出願人】(000000240)太平洋セメント株式会社 (1,449)
【Fターム(参考)】
【公開日】平成25年6月10日(2013.6.10)
【国際特許分類】
【出願日】平成23年11月30日(2011.11.30)
【出願人】(000000240)太平洋セメント株式会社 (1,449)
【Fターム(参考)】
[ Back to top ]

